- 科學島團隊在3D先進封裝的TGV技術上取得重要突破
中安在線、中安新聞客戶端訊 近期,中科院合肥研究院智慧所陳池來課題組李山博士等取得重要技術突破,團隊攻克了高均一性玻璃微孔陣列製造、玻璃緻密回流、玻璃微孔金屬高緻密填充等技術難題,發展了一種面向3D先進封裝的玻璃金屬穿孔工藝(ThroughGlassVia, TGV),可實現高頻晶片、先進MEMS感測器的低傳輸損耗、高真空晶圓級封裝。基於該技術成果申請發明專利5項,依託該技術的相關研究發表在感測器領域top期刊上Sensors and Actuators: B. Chemical上。

基於導電硅的TGV晶圓(可定制4、6英寸)
近年來,晶片與電子産品中高性能、高可靠性、高密度集成的強烈需求催生了3D封裝技術並使其成為積體電路發展的主要推動力量之一。傳統的平面化2D封裝已經無法滿足高密度、輕量化、小型化的強烈需求。玻璃金屬穿孔(TGV)是一種應用於圓片級真空封裝領域的新興縱向互連技術,為實現晶片-晶片之間距離最短、間距最小的互聯提供了一種新型技術途徑,具有優良的電學、熱學、力學性能,在射頻晶片、高端MEMS感測器、高密度系統集成等領域具有獨特優勢,是下一代5G、6G高頻晶片3D封裝的首選之一。
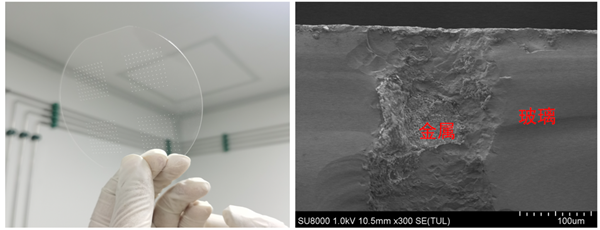
基於導電金屬的TGV晶圓(可定制4、6、8英寸)
為此,團隊針對TGV現有工藝問題,結合中科院合肥研究院和中國科學技術大學微納研究與製造中心的前期研究基礎及平臺優勢,提出一種新型TGV晶圓製造方案,開發出了高均一性、高緻密、高深寬比的TGV晶圓,具有超低漏率、超低信號損耗的優勢,滿足環形諧振器、波導縫隙天線、毫米波天線等5G/6G高頻晶片,以及新型MEMS陀螺儀、加速度計3D封裝需求。經檢測,團隊研製出的TGV晶圓各項主要參數均與國際頂級玻璃廠商肖特、康寧和泰庫尼思科等相當,部分參數優於國際水準。
該項技術具有高度靈活性,可滿足客戶諸多定制化需求,經濟效益、行業意義重大,在半導體晶片3D先進封裝、射頻晶片封裝、MEMS感測器封裝,以及新型MEMS感測器(MEMS質譜、MEMS遷移譜)設計製造、新型玻璃基微流控晶片製作等多個領域具有廣闊的應用前景。
相關技術得到了國家自然科學基金、科技部、中科院、安徽省等來源項目的支持。(吳銀亭 記者 張毅璞 徐慧媛)
